글/ 라미로 가스콘(Ramiro Gascon), 온세미(onsemi) 제품 라인 매니저
완전 전기화와 마찬가지로 완전 자율주행은 차량 설계 및 제조에서 차세대 패러다임이 될 것이다. 첨단운전자지원시스템(ADAS)으로 지원되는 반자율주행은 이미 외부 센서와 온보드 카메라의 데이터 융합을 비롯해 다양한 애플리케이션을 관리하는 전자제어장치(ECU) 수를 크게 증가시켰다. 이러한 제어기의 전력 소비는 데이터 처리량과 속도에 따라 증가한다.
새로운 제어기는 주차 보조 센서를 관리하는 ECU와 같이 한 자릿수 와트의 출력 전력 용량을 갖는 전압 레귤레이터부터, 여러 비디오 스트림을 처리하는 ECU와 같이 100와트 이상의 출력 전력 용량을 갖는 전압 레귤레이터를 필요로 한다. 열 발생은 전력 손실의 불가피한 부작용이며, 과열을 방지하고자 PCB에 부품을 가깝게 배치할 수 있는 범위를 제한한다. 이는 특히 공간과 무게가 주행 거리에 부정적인 영향을 주는 전기차 OEM의 경우 문제가 된다.
자동차 애플리케이션의 고전력 스텝다운 변환에는 효과적인 열 관리가 매우 중요하다. 기존 하부 냉각(BSC) 기술에는 한계가 있고, 전력 밀도가 증가함에 따라 새로운 솔루션이 필요하다. 본 기고에서는 부품 패키징의 혁신인 상부 냉각(TSC)이 과도한 열 방출 문제를 해결하고 더 작고 가벼운 자동차에서 보다 높은 전력 밀도를 실현하는 방법에 대해 설명한다.
하부 냉각(BSC)
최근 고전력 애플리케이션에 사용되는 대부분의 표면실장 디바이스(SMD)는 실리콘 다이의 열을 방출하기 위해 BSC를 사용한다. SMD 패키지 하단의 금속 패드는 보드 비아(board vias)를 통해 PCB 아래 히트 싱크에 연결된다. 그러나 이러한 접근 방식에는 몇 가지 위험 요소가 있다. PCB 내부의 온도 상승은 PCB 근처에 실장된 다른 부품의 작동에 부정적인 영향을 미칠 수 있으며, 고온에 장시간 노출될 경우 PCB가 박리되어 시스템 수명이 단축될 수도 있다.
그림 1. 하부 냉각 기능 보유한 SMD: 열은 비아 및 PCB를 통해 방출이 된다.
상부 냉각(TSC)
TSC는 열 방출을 위한 직접적인 열 경로를 제공하며, 전력 반도체 디바이스에 부착된 히트 싱크로 열을 더 잘 전달할 수 있는 대안이다. TSC는 BSC에 비해 열 성능이 최대 70% 향상되어 시스템 작동 온도를 낮추고 효율을 개선할 수 있으며, 이는 자동차 애플리케이션의 고전력 스텝다운 전압 변환에서 매우 중요한 요소이다. 또한 TSC는 뛰어난 열 성능 외에도 PCB 설계에 몇 가지 이점을 제공한다.
그림 2. 상부 냉각 기능 보유한 SMD: 써멀 비아가 필요하지 않다.
기계적 안정성 향상
히트 싱크를 패키지 상단에 직접 부착하면 디바이스 또는 보드에 기계적 스트레스나 손상이 발생할 위험이 크게 감소해 신뢰성이 향상되고 부품의 수명이 연장된다.
더욱 컴팩트한 디자인
TSC는 팬이나 기타 냉각 디바이스를 위한 충분한 공간이 필요한 공냉식보다 더 컴팩트한 보드 설계를 가능하게 한다. 따라서 TSC 디바이스는 전체 시스템 크기와 무게를 줄이며, 이는 공간이 제한된 자동차 애플리케이션에서 매우 중요하다.
PCB 면적이 제한된 실제 ECU에서는 부품에서 발생하는 대부분의 열이 인클로저에서 빠져나간다. TSC 패키지는 상단의 노출된 패드가 인클로저와 직접 접촉하므로 대부분의 열이 상단에서 흐르기 때문에 이러한 조건에 적합하다. 반대로, 온도를 크게 높이지 않고도 적당한 양이 아래쪽에서 PCB를 통해 흐른다. 양쪽에서 열이 흐르게 함으로써 PCB 수명이 연장되고 시스템 신뢰성이 향상된다.
열량에 대한 이해
디바이스의 열 특성을 고려할 때 열 흐름이 어떻게 모델링되는지 이해해보자. 열전도율은 모양과 크기에 의존하지 않는 소재의 특성이다. 이는 물체가 내부적으로 열을 전도하는 능력을 말하며 서로 다른 재료를 비교할 때 유용하다. 열 저항은 재료가 열의 흐름에 저항하는 방식을 말하고 재료의 두께는 열 저항에 영향을 미치는데 얇은 재료는 두꺼운 재료보다 더 많은 열을 전달할 수 있다. 열 임피던스는 재료의 모양, 크기, 두께, 압력과 관련이 있다. 이는 표면 평탄도와 애플리케이션에서 부품이 받는 응력과 같은 변수를 고려하는 보다 실용적인 수치이다. 히트 싱크를 디바이스에 부착할 때 가해지는 토크는 열 임피던스에 영향을 미치는데, 압착 수준이 높을수록 열 저항이 낮아진다.
DC-DC 컨버터의 BSC 및 TSC 성능 비교
온세미는 냉각 메커니즘이 다른 디바이스의 성능을 비교하기 위해 모든 PCB 레이어에 넓은 면적의 구리로 최적화된 100W 벅 컨버터 프로토타입 보드를 사용해 TSC와 BSC 디바이스에 유사한 열 성능을 제공했다.
이 테스트 설정은 냉각 핀이 있는 맞춤형 알루미늄 하우징 내부의 복잡한 ECU용 전원 공급 장치와 같이 실제 애플리케이션과 동일하지는 않지만, 히트 싱크의 열 저항과 갭 패드 두께를 비롯한 매개 변수가 MOSFET 온도에 미치는 영향을 입증하는 데는 충분하다. 또한 히트 싱크를 열원(DC-DC 컨버터의 로우 사이드 MOSFET) 위에 장착하거나 PCB의 반대편에 장착하는 경우에도 유사한 열 성능을 제공할 수 있다. 이는 PCB 레이아웃이 써멀 비아와 모든 레이어의 넓은 구리 영역에 열적으로 최적화되어 기판을 통한 열 흐름을 원활하게 한다는 가정에 기반한다. 또한 TSC MOSFET의 노출된 패드는 히트 싱크에 직접 연결하여 PCB로의 열 흐름을 최소화해야 한다.
그림 3. TSC(왼쪽) 및 BSC(오른쪽)가 실장된 테스트 보드
측정 결과
이 테스트 설정의 결과, 히트 싱크를 TSC MOSFET 상단에 장착할 경우와 BSC MOSFET을 사용해 열적으로 최적화된 PCB의 하단에 장착할 경우 MOSFET 온도(Tc)에서 약간의 차이(<3°C)만이 관찰됐다. 20A 부하 전류에 대해 히트 싱크를 전혀 사용하지 않은 경우와 비교했을 때, 두 경우 모두 MOSFET 온도는 대략 비슷했다:
• 60mm 히트 싱크 사용 시 30°C 더 낮음
• 25mm 히트 싱크 사용 시 15~20°C 더 낮음
• 10mm 히트 싱크 사용 시 10°C 더 낮음
결과적으로 히트 싱크가 있는 TSC MOSFET이 주변 부품의 밀도가 낮고 열적으로 최적화된 PCB에 장착된 BSC MOSFET과 유사한 열 성능을 제공한다는 것을 보여준다. 그러나 PCB로 유입되는 열을 최소화해야 하는 경우, 패키지 상단에 장착된 히트 싱크에 대한 열 저항이 더 낮기 때문에 상단이 노출된 패드가 있는 MOSFET이 적절하다.
냉각 이상의 이점을 제공하는 TSC
온세미에서는 5mm x 7mm 크기의 TCPAK57 패키지 제품의 NVMJST0D9N04C와 같은 자동차 애플리케이션용 TSC MOSFET을 제공한다. 해당 디바이스는 상단에 16.5mm2의 열 패드가 있어, PCB가 아닌 히트 싱크로 열을 직접 방출한다. PCB의 양면을 모두 사용할 수 있으며, 기판으로 들어가는 열의 양을 줄인다. 따라서 TCPAK57 패키지는 전력 밀도를 높이고 신뢰성을 향상시키며 시스템 수명을 전반적으로 연장할 수 있다.
저작권©올포칩 미디어. 무단전재 및 재배포를 금지합니다.
 결정론, 새로운 이더넷 애플리케이션을 열다새로운 네트워크 프로토콜은 성능에서 다른 부분들이 있지만, 일반적으로 더 많은 데이터 처리량을 제공하기 위해 개발된다. 예를 들어, 공장, 건물의 센서와 액추에이터는 데이터가 거의 필요하지 않지만 ‘엣지’에서 작동하려면 다른 사항들이 요구된다.
결정론, 새로운 이더넷 애플리케이션을 열다새로운 네트워크 프로토콜은 성능에서 다른 부분들이 있지만, 일반적으로 더 많은 데이터 처리량을 제공하기 위해 개발된다. 예를 들어, 공장, 건물의 센서와 액추에이터는 데이터가 거의 필요하지 않지만 ‘엣지’에서 작동하려면 다른 사항들이 요구된다. 센서를 이용한 소방관들의 안전 개선재난 현장에서 소방관들이 소지하는 응급 구조 장비들 외에도, 이들의 안전을 위해서 다양한 방식으로 첨단 기술을 활용할 수 있다. 웨어러블 기술을 활용해서 팀원 중의 누군가 심박수나 혈압이 급격히 상승하거나 여타 생체 데이터가 변화되는 것을 감독관에게 알려줄 수 있으며, 환경 센서들을 사용해서 주변 환경으로 어떠한 유독성 화학 물질이 존재하는지 파악할 수 있다.
센서를 이용한 소방관들의 안전 개선재난 현장에서 소방관들이 소지하는 응급 구조 장비들 외에도, 이들의 안전을 위해서 다양한 방식으로 첨단 기술을 활용할 수 있다. 웨어러블 기술을 활용해서 팀원 중의 누군가 심박수나 혈압이 급격히 상승하거나 여타 생체 데이터가 변화되는 것을 감독관에게 알려줄 수 있으며, 환경 센서들을 사용해서 주변 환경으로 어떠한 유독성 화학 물질이 존재하는지 파악할 수 있다. 동적 전압 스케일링을 활용한 정밀 전압 레귤레이션이 글에서는 동적 전압 스케일링(DVS: Dynamic Voltage Scaling)을 활용하여 정밀 전압 레귤레이션을 달성하는 방법에 대해 알아본다. DVS는 부하 트랜션트를 예상하여 출력 전압을 약간 높이거나 낮추도록 조절하는 프로세스를 말한다. 또한 이 글에서는 특정 IC를 사용해서 신뢰할 수 있는 전압 모니터링을 달성하는 방법에 대해서도 설명한다.
동적 전압 스케일링을 활용한 정밀 전압 레귤레이션이 글에서는 동적 전압 스케일링(DVS: Dynamic Voltage Scaling)을 활용하여 정밀 전압 레귤레이션을 달성하는 방법에 대해 알아본다. DVS는 부하 트랜션트를 예상하여 출력 전압을 약간 높이거나 낮추도록 조절하는 프로세스를 말한다. 또한 이 글에서는 특정 IC를 사용해서 신뢰할 수 있는 전압 모니터링을 달성하는 방법에 대해서도 설명한다. 전기기계적 접속을 위한 1-Wire Contact Package 부착 방법이 글에서는 전기기계적 접속을 위한 아나로그디바이스(Analog Devices)의 특허기술인 1-Wire Contact Package 솔루션에 대해 알아보고, 기존 패키징 솔루션과 비교해 1-Wire Contact Package 솔루션의 장점에 대해 살펴보고자 한다. 이와 함께 액세서리나 소모품에 이 솔루션을 부착하는 방법을 설명하고, 기계적 특징들과 신뢰성 분석 정보들을 제공한다.
전기기계적 접속을 위한 1-Wire Contact Package 부착 방법이 글에서는 전기기계적 접속을 위한 아나로그디바이스(Analog Devices)의 특허기술인 1-Wire Contact Package 솔루션에 대해 알아보고, 기존 패키징 솔루션과 비교해 1-Wire Contact Package 솔루션의 장점에 대해 살펴보고자 한다. 이와 함께 액세서리나 소모품에 이 솔루션을 부착하는 방법을 설명하고, 기계적 특징들과 신뢰성 분석 정보들을 제공한다. 자율이동로봇 설계시 고려 사항과 솔루션자율이동로봇(AMR)은 제조, 물류와 창고, 농업, 소매업, 서비스업 등 다양한 산업 분야에서 점점 더 보편화되고 있다. 이러한 로봇은 효율성 향상, 생산성 증대, 안전한 작업 환경 등 여러 가지 이점을 제공한다. 본 기고에서는 모터와 컨트롤러, 센서, 조명, 통신 인터페이스를 비롯한 AMR 애플리케이션과 구성에 사용되는 다양한 부품들에 대한 요구 사항에 대해 설명한다. 또한 이러한 다양한 요구 사항을 신속하게 해결할 수 있는 온세미의 적절한 솔루션도 제안한다.
자율이동로봇 설계시 고려 사항과 솔루션자율이동로봇(AMR)은 제조, 물류와 창고, 농업, 소매업, 서비스업 등 다양한 산업 분야에서 점점 더 보편화되고 있다. 이러한 로봇은 효율성 향상, 생산성 증대, 안전한 작업 환경 등 여러 가지 이점을 제공한다. 본 기고에서는 모터와 컨트롤러, 센서, 조명, 통신 인터페이스를 비롯한 AMR 애플리케이션과 구성에 사용되는 다양한 부품들에 대한 요구 사항에 대해 설명한다. 또한 이러한 다양한 요구 사항을 신속하게 해결할 수 있는 온세미의 적절한 솔루션도 제안한다.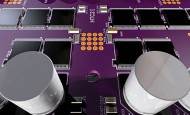 차량용 배터리 성능을 향상시키는 IOXUS의 uSTART 울트라 커패시터차량용 모터는 정차 후 출발할 때마다 상당한 양의 연료를 소모하고 부품들을 더 빨리 마모시킨다. 이 글에서는 IOXUS의 uSTART 울트라 커패시터를 활용해서 차량이 정차했다 출발할 때 배터리와 함께 높은 출력을 제공함으로써 연료 소모를 저감하고 부품 마모를 늦추며 향상된 시스템 성능을 달성할 수 있다는 것을 설명한다.
차량용 배터리 성능을 향상시키는 IOXUS의 uSTART 울트라 커패시터차량용 모터는 정차 후 출발할 때마다 상당한 양의 연료를 소모하고 부품들을 더 빨리 마모시킨다. 이 글에서는 IOXUS의 uSTART 울트라 커패시터를 활용해서 차량이 정차했다 출발할 때 배터리와 함께 높은 출력을 제공함으로써 연료 소모를 저감하고 부품 마모를 늦추며 향상된 시스템 성능을 달성할 수 있다는 것을 설명한다. 소형 자산추적 장치의 배터리 수명을 연장하는 소형 고효율 벅 컨버터오늘날에는 새로운 저전력 데이터 네트워크의 낮은 구축 비용 덕분에 자산 추적 솔루션이 폭발적으로 증가했다. 이러한 영향은 운송이나 공급망 관리 같은 애플리케이션에서 두드러지게 나타나고 있다. 이러한 애플리케이션에서 센서는 주어진 위치에서 업데이트를 하고 온도, 습도, 압력, 모션 같은 데이터를 전송한다. 센서는 소량의 데이터만 전송하면 되므로 커버리지를 높이고 전력 소모를 최소화하여 기기를 더 긴 시간 동안 사용할 수 있게 한다. 이러한 센서의 배터리는 수 주일에서 길게는 수 년 동안 지속할 수 있어야 한다.
소형 자산추적 장치의 배터리 수명을 연장하는 소형 고효율 벅 컨버터오늘날에는 새로운 저전력 데이터 네트워크의 낮은 구축 비용 덕분에 자산 추적 솔루션이 폭발적으로 증가했다. 이러한 영향은 운송이나 공급망 관리 같은 애플리케이션에서 두드러지게 나타나고 있다. 이러한 애플리케이션에서 센서는 주어진 위치에서 업데이트를 하고 온도, 습도, 압력, 모션 같은 데이터를 전송한다. 센서는 소량의 데이터만 전송하면 되므로 커버리지를 높이고 전력 소모를 최소화하여 기기를 더 긴 시간 동안 사용할 수 있게 한다. 이러한 센서의 배터리는 수 주일에서 길게는 수 년 동안 지속할 수 있어야 한다. 피에조-포토트로닉스란 무엇인가?피에조일렉트릭(압전) 소자는 기계적 스트레스나 하중이 가해졌을 때 전기 전하를 발생시키는 소자들을 총칭하는 것이다. 어떤 형태의 물리적 변형이든 전기 전하를 발생시킨다. 피에조일렉트릭 소자는 다양한 애플리케이션과 전자 시스템에 활용되고 있다.
피에조-포토트로닉스란 무엇인가?피에조일렉트릭(압전) 소자는 기계적 스트레스나 하중이 가해졌을 때 전기 전하를 발생시키는 소자들을 총칭하는 것이다. 어떤 형태의 물리적 변형이든 전기 전하를 발생시킨다. 피에조일렉트릭 소자는 다양한 애플리케이션과 전자 시스템에 활용되고 있다. 스마트 팩토리 요건에 부합하는 RTD 기반 온도 센서 재설계 방법이 글에서는 더 작은 폼 팩터, 유연한 통신, 원격 설정 기능을 갖춘 온도 측정 장치에 대한 스마트 팩토리의 요구 사항을 충족하기 위해 저항 온도 감지기(resistance temperature detector, RTD) 산업용 온도 센서를 신속하게 재설계하는 방법에 대해 설명한다. 통합 수준이 높은 아날로그 프런트 엔드(AFE)와 IO-Link® 송수신기를 사용함으로써 이 작업을 수행할 수 있다.
스마트 팩토리 요건에 부합하는 RTD 기반 온도 센서 재설계 방법이 글에서는 더 작은 폼 팩터, 유연한 통신, 원격 설정 기능을 갖춘 온도 측정 장치에 대한 스마트 팩토리의 요구 사항을 충족하기 위해 저항 온도 감지기(resistance temperature detector, RTD) 산업용 온도 센서를 신속하게 재설계하는 방법에 대해 설명한다. 통합 수준이 높은 아날로그 프런트 엔드(AFE)와 IO-Link® 송수신기를 사용함으로써 이 작업을 수행할 수 있다. 전압 컨버터를 활용하여 배터리 효율을 높이고 사용 시간을 늘리는 방법이 글에서는 기존 시스템에 아나로그디바이스(ADI)의 나노파워(nanoPower) 컨버터를 이용하여 배터리 사용 시간을 최대 20% 더 늘리는 방법에 대해 설명한다.
회로의 에너지 효율이 좋아야 배터리가 오랫동안 지속될 수 있다. 이러한 이유에서 시스템 설계 시 에너지 효율이 우수한 부품들을 선택해야 한다. 전자 회로에서 기능 블록의 수가 적을수록 시스템 전반에서 더 높은 에너지 효율을 달성할 수 있다. 그림 1은 배터리 전원으로 작동하는 장치의 사례로서 전자식 수도 계량기를 나타낸 것이다. 이 시스템은 아나로그디바이스의 MAX32662 마이크로컨트롤러를 기반으로 하며, 하나의 전원 전압만을 사용한다. 입력 전압 범위는 1.71V ~ 3.63V이다.
전압 컨버터를 활용하여 배터리 효율을 높이고 사용 시간을 늘리는 방법이 글에서는 기존 시스템에 아나로그디바이스(ADI)의 나노파워(nanoPower) 컨버터를 이용하여 배터리 사용 시간을 최대 20% 더 늘리는 방법에 대해 설명한다.
회로의 에너지 효율이 좋아야 배터리가 오랫동안 지속될 수 있다. 이러한 이유에서 시스템 설계 시 에너지 효율이 우수한 부품들을 선택해야 한다. 전자 회로에서 기능 블록의 수가 적을수록 시스템 전반에서 더 높은 에너지 효율을 달성할 수 있다. 그림 1은 배터리 전원으로 작동하는 장치의 사례로서 전자식 수도 계량기를 나타낸 것이다. 이 시스템은 아나로그디바이스의 MAX32662 마이크로컨트롤러를 기반으로 하며, 하나의 전원 전압만을 사용한다. 입력 전압 범위는 1.71V ~ 3.63V이다. 산업용 모터 제어 개선하는 유도 위치 센서현대의 많은 기계 중심에는 최소한 하나의 모터가 있다. 로봇, 엘리베이터, 자동차, 전동 공구 등의 발전을 위해서는 모터를 더욱 정밀하게 제어하는 것이 중요하다. 모터의 성능은 정밀한 제어 능력으로 결정되고, 정밀한 제어 능력은 모터의 위치를 정확하게 감지하는 것에 달려 있다. 그리고 정밀한 감지 능력 정확한 센서 기술의 성장에 의존한다.
산업용 모터 제어 개선하는 유도 위치 센서현대의 많은 기계 중심에는 최소한 하나의 모터가 있다. 로봇, 엘리베이터, 자동차, 전동 공구 등의 발전을 위해서는 모터를 더욱 정밀하게 제어하는 것이 중요하다. 모터의 성능은 정밀한 제어 능력으로 결정되고, 정밀한 제어 능력은 모터의 위치를 정확하게 감지하는 것에 달려 있다. 그리고 정밀한 감지 능력 정확한 센서 기술의 성장에 의존한다. 효율과 지속 가능성을 고려한 스마트 빌딩 설계스마트 빌딩은 인텔리전트 에지 기술을 활용하여 사물 인터넷(IoT) 연결 장치와 증강 현실(AR), 시각 및 모션 센서, 그 밖에 다른 시스템을 통합하여 실내 온도 조절, 보안, 조명 등 일상적인 제어 업무를 자동화하는 것으로, 이 모든 것은 효율 극대화와 입주자의 경험 향상으로 이어진다.
효율과 지속 가능성을 고려한 스마트 빌딩 설계스마트 빌딩은 인텔리전트 에지 기술을 활용하여 사물 인터넷(IoT) 연결 장치와 증강 현실(AR), 시각 및 모션 센서, 그 밖에 다른 시스템을 통합하여 실내 온도 조절, 보안, 조명 등 일상적인 제어 업무를 자동화하는 것으로, 이 모든 것은 효율 극대화와 입주자의 경험 향상으로 이어진다. PoE 용 전원 서브시스템 설계PoE(Power over Ethernet) 기술을 활용하면 기존의 CAT5/5e/6 이더넷 케이블을 통해 데이터 전송과 전원 공급을 할 수 있다. 이 글에서는 PoE 시스템 설계, 그 중에서도 특히 PD(powered device) 전원 서브시스템 설계에 관해서 자세히 알아본다.
PoE 용 전원 서브시스템 설계PoE(Power over Ethernet) 기술을 활용하면 기존의 CAT5/5e/6 이더넷 케이블을 통해 데이터 전송과 전원 공급을 할 수 있다. 이 글에서는 PoE 시스템 설계, 그 중에서도 특히 PD(powered device) 전원 서브시스템 설계에 관해서 자세히 알아본다. 자동차 ADAS를 위한 향상된 고전류 스위칭 전원장치 설계 방법운전이나 주차 시 운전자를 보조하는 ADAS가 빠르게 진보하고 있다. 진보된 ADAS일수록 이전 세대 기술보다 더 많은 전력을 소모한다. 따라서 저전류 스위칭 레귤레이터는 이처럼 갈수록 높아지는 전력 요구를 더 이상 충족할 수 없게 되었다.
자동차 ADAS를 위한 향상된 고전류 스위칭 전원장치 설계 방법운전이나 주차 시 운전자를 보조하는 ADAS가 빠르게 진보하고 있다. 진보된 ADAS일수록 이전 세대 기술보다 더 많은 전력을 소모한다. 따라서 저전류 스위칭 레귤레이터는 이처럼 갈수록 높아지는 전력 요구를 더 이상 충족할 수 없게 되었다.
 로지텍, 미니멀 라이프를 즐기자: ‘미니멀테리어’에 최적화된 추천 아이템 3
로지텍, 미니멀 라이프를 즐기자: ‘미니멀테리어’에 최적화된 추천 아이템 3 마이크로칩, 임베디드 보안 기능을 간단하게 통합할 수 있는 32비트 마이크로컨트롤러 출시
마이크로칩, 임베디드 보안 기능을 간단하게 통합할 수 있는 32비트 마이크로컨트롤러 출시 한국마이크로소프트, AI 기술의 미래 조명하는 ‘AI Tour in Seoul’ 개최
한국마이크로소프트, AI 기술의 미래 조명하는 ‘AI Tour in Seoul’ 개최 미루웨어, 국제인공지능대전(AI EXPO) 2024 참가
미루웨어, 국제인공지능대전(AI EXPO) 2024 참가 플리어의 T5xx 전문가용 열화상 카메라, 전기시설 점검을 위한 필수 장비로 활용
플리어의 T5xx 전문가용 열화상 카메라, 전기시설 점검을 위한 필수 장비로 활용
- 델 테크놀로지스 보고서, 생성형 AI가 기업의 성과 창출에 기여
- KT, 안전 플랫폼 ‘올 인 세이프티’ 도입으로 AI 기반 안전 관리 기능 강화
- 페펄앤드푹스, Ethernet-APL 기반의 액티브 인프라 지원
- NCH코리아, 산업 윤활관리 프로그램 런칭
- 로지텍, ‘시그니처 슬림’ 시리즈로 뛰어난 멀티 디바이스 경험 제공
- 마우저, 인텔의 새로운 독립 FPGA 기업인 알테라 제품 공급
그래픽 / 영상
 지멘스 EDA, 최첨단 SoC 설계를 위한 혁신적인 에뮬레이션 및 프로토타이핑 솔루션 발표
지멘스 EDA, 최첨단 SoC 설계를 위한 혁신적인 에뮬레이션 및 프로토타이핑 솔루션 발표 블루투스 지원 기기 출하량, 향후 5년 동안 연평균 8% 성장 전망
블루투스 지원 기기 출하량, 향후 5년 동안 연평균 8% 성장 전망 인터넷의 ‘필터 버블(Filter Bubble)’ 깨부수기
인터넷의 ‘필터 버블(Filter Bubble)’ 깨부수기
많이 본 뉴스
 키사이트, 와이파이 7용 무선 테스트 플랫폼 출시
키사이트, 와이파이 7용 무선 테스트 플랫폼 출시 알테라, 인텔에서 다시 FPGA 기업으로 독립
알테라, 인텔에서 다시 FPGA 기업으로 독립 ST, 비용 효율적인 차세대 마이크로컨트롤러 위해 20nm 장벽 극복
ST, 비용 효율적인 차세대 마이크로컨트롤러 위해 20nm 장벽 극복 서비스나우, 국내 금융 업계의 AI 기반 플랫폼 IT 혁신 지원 본격화
서비스나우, 국내 금융 업계의 AI 기반 플랫폼 IT 혁신 지원 본격화 ST, 집약적 움직임 분석 지원하는 관성 모듈로 엣지-AI 센서 제품군 확장
ST, 집약적 움직임 분석 지원하는 관성 모듈로 엣지-AI 센서 제품군 확장 탈레스 알레니아 스페이스, 국내 최초 정찰위성 ‘425사업’ 위성의 성공적 발사 지원
탈레스 알레니아 스페이스, 국내 최초 정찰위성 ‘425사업’ 위성의 성공적 발사 지원 GaN FET를 이용한 고성능 클래스-D 오디오 증폭기 설계
GaN FET를 이용한 고성능 클래스-D 오디오 증폭기 설계 피커링, 80W의 스위치를 제공하는 고전력 시리즈 144 리드 릴레이 출시
피커링, 80W의 스위치를 제공하는 고전력 시리즈 144 리드 릴레이 출시 마우저, 웨어러블 리소스 센터를 통해 엔지니어를 위한 포괄적인 콘텐츠 제공
마우저, 웨어러블 리소스 센터를 통해 엔지니어를 위한 포괄적인 콘텐츠 제공 미르, AI 기반 자율이동로봇으로 혁신적인 팔레트 물류 자동화 지원
미르, AI 기반 자율이동로봇으로 혁신적인 팔레트 물류 자동화 지원