프랙틸리아의 FAME(Fractilia Automated Measurement Environment) 제품은 LER(line-edge roughness)/LWR(linewidth roughness), LCDU(local CD uniformity), LEPE(local edge placement error), 스토캐스틱 결함 등 모든 주요 스토캐스틱 효과를 동시에 측정한다.
프랙틸리아(Fractilia)는 현재 스토캐스틱(stochastic)기반 분석과 제어를 이끌어가는 차세대 반도체 산업 주자로서 새로운 프로그램을 발표했다. 프랙틸리아는 자사의 FAME(Fractilia Automated Measurement Environment; 프랙틸리아 자동화 측정 환경)을 사용하여 주사전자현미경(Scanning Electron Microscope, 이하 SEM)의 5 ~ 20배 개선된 SEM장비 매칭과 30배 향상된 SEM처리량을 기대할 수 있는 이 프로그램을 칩 제조사에게 조건 없이 제공한다고 밝혔다.
“프랙틸리아 챌린지” 프로그램은 BKM(best known method; 반도체업계에서 주어진 프로세스를 얼마나 잘 수행하는지에 대한 평가 기준)을 사용하여 SEM 장비로 실험에 참여할 의향이 있는 칩 제조사를 모집한다. 칩 제조사가 SEM 이미지를 보내면, 프랙틸리아는 해당 이미지들을 FAME으로 분석하여 SEM 장비 성능, SEM 장비간 매칭 가능성 및 처리량 개선에 대해 기술한 맞춤형 보고서를 제공한다. FAME은 첨단 노드 공정에서 패터닝 오류의 주된 원인인 CD(Critical Dimension; 최소 선폭)와 다양한 스토캐스틱 효과를 고도로 정확하고 정밀하게 측정할 수 있는 유일한 팹 솔루션이다.
프랙틸리아 챌린지는 기존 고객의 SEM장비간 매칭을 5 ~ 20배 개선하는 한편, SEM장비의 처리량을 30퍼센트 이상 증대해왔다. 동일한 세대와 유형의SEM장비뿐 아니라 다른 세대 혹은 다른 회사의SEM 장비들 간에도 매칭을 가능하게 한다. 이러한 혁신적인 성능은 라인 에지 거칠기(LER, line edge roughness), 라인 폭 거칠기(LWR, line width roughness), 국부적 CD 균일성(LCDU, local CD uniformity) 등을 포함한 수많은 스토캐스틱 측정으로 실현 가능하다.
FAME을 통한 SEM 장비간 매칭의 향상에는 많은 이점이 있다. SEM 측정 정밀도와 안정성을 높임으로써 공정 수율 향상, 특정 레이어에 할당된 전용 SEM 의존성 감소로 전반적인 장비 효율 증대, 새로운 디바이스 노드 측정에 이전 세대의 SEM 재사용으로 새로운 장비에 대한 구입 비용 절감을 기대할 수 있다. FAME은 측정 정확도나 정밀도에 대한 영향 없이 SEM 장비 처리량을 향상시킨다. 따라서 동일한 측정에 대해 더 적은 수의 SEM을 사용할 수 있으며 고객의 비용과 클린룸 공간 절약이 가능하다.
프랙틸리아의 에드 샤리에(Ed Charrier) 사장 겸 CEO는 “지난 수십 년 동안 칩 제조사와 SEM 장비 회사들은 더 우수한 SEM 장비 매칭을 달성하기 위해서 매년 수백만 달러를 지출해 왔다. 프랙틸리아는 독창적인 접근법을 통해 비교할 수 없이 높은 수준의 매칭 결과를 달성한다. 최근 다양한 고객들과 함께 여러 SEM 장비와 다른 세대간 SEM 장비간 매칭에서 0.02nm LWR 정밀도를 달성하는 능력을 입증 및 시연했다. 백 번 듣는 것보다 한 번 보는 것이 낫다는 말이 있듯이, ‘프랙틸리아 챌린지’는 FAME 제품이 어떻게 칩 제조사의 기존 SEM 장비 환경을 활용하여 SEM 장비간 매칭을 개선하고, 그와 동시에 SEM 장비 처리량을 증가시키는지 반도체 업계에 직접 입증할 수 있는 기회가 될 것”이라고 말했다.
프랙틸리아의 크리스 맥(Chris Mack) CTO는 “SEM 장비 간 0.02nm 미만의 LWR 매칭을 달성하려면 새로운 패러다임이 필요하다. 많은 이들이 해당 수준의 매칭은 불가능하다고 말하지만, 전산 계측(computational metrology)을 통해 SEM의 오차를 측정하고 제거함으로써 실현하고 있다. 우리는 웨이퍼를 찍은 이미지가 아닌 실제 웨이퍼 위에 무엇이 있는지를 측정한다”고 덧붙였다.
프랙틸리아의 FAME 제품군은 스토캐스틱을 고도로 정확하고 정밀하게 측정할 수 있다. 스토캐스틱(stochastic)은 무작위로 발생하는 반복적이지 않은 패터닝 오류로서, EUV 공정에서 전체 패터닝 오류 예산의 절반 이상을 차지한다. FAME은 독자적이고 고유한 물리학에 기반한 SEM 모델링 및 데이터 분석 접근법을 사용한다. SEM 이미지로부터 오는 무작위(random) 오차와 시스템(systematic) 오차를 측정하고 제거함으로써 이미지 상에 보이는 것이 아니라 실제 웨이퍼 모습을 정확하게 측정한다. 이처럼 ‘편향되지 않은(unbiased)’ 스토캐스틱 측정은 팹 엔지니어가 첨단 패터닝 공정에서 수율 문제를 더 잘 이해하고 해결할 수 있도록 하며, 이는 디바이스 수율과 패터닝 생산성을 높이는 결과로 이어진다. FAME의 최신 버전인 FAME 3.1은 프랙틸리아의 검증된 3세대 FILM™(Fractilia Inverse Linescan Model) 플랫폼을 기반으로 하며, 세계의 주요 칩 제조사, 연구소, 장비 회사, 반도체 원재료 공급사들에 널리 사용된다.
저작권©올포칩 미디어. 무단전재 및 재배포를 금지합니다.
- 온세미, CES 2023서 지능형 솔루션 공개볼륨 불(volume boule)의 성장부터 동급 최고의 통합 모듈, 개별 패키지 솔루션 및 애플리케이션에 이르기까지 온세미의 엔드 투 엔드 실리콘 카바이드(SiC) 공급망은 시현을 주도할 것이다. 여기에는 트랙션 인버터, 온보드 충전 및 전기 자동차 충전도 포함된다. 온세미의 수직적 통합으로 OEM은 SiC 기술 및 공급 보증에 대한 전문성을 기대할 수 있다.
 지멘스, 하마마츠 포토닉스의 광 반도체 설계위해 전력 무결성 분석 솔루션 공급지멘스의 mPower 디지털 소프트웨어는 빠르고 효율적인 분산처리를 통해 전력 무결성 분석을 높은 정확도로 제공한다. 직관적인 그래픽 사용자 인터페이스로 최적의 사용 편의성을 제공하는 이 솔루션은 초기 개념 설계로부터 설계 사인오프에 이르기까지 IC 설계 프로세스 전반에 걸친 분석을 지원하여 사용자가 품질이나 속도의 저하 없이 보다 우수한 설계를 개발할 수 있도록 지원한다.
지멘스, 하마마츠 포토닉스의 광 반도체 설계위해 전력 무결성 분석 솔루션 공급지멘스의 mPower 디지털 소프트웨어는 빠르고 효율적인 분산처리를 통해 전력 무결성 분석을 높은 정확도로 제공한다. 직관적인 그래픽 사용자 인터페이스로 최적의 사용 편의성을 제공하는 이 솔루션은 초기 개념 설계로부터 설계 사인오프에 이르기까지 IC 설계 프로세스 전반에 걸친 분석을 지원하여 사용자가 품질이나 속도의 저하 없이 보다 우수한 설계를 개발할 수 있도록 지원한다.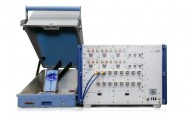 로데슈바르즈와 낫싱 테크놀로지, 새로운 5G 지원 낫싱 폰원 출시 위해 협력R&S CMX500 원박스 신호 테스터를 이용한 R&D 과정의 협력을 통해 낫싱 테크놀로지의 새로운 Phone (1)에 대한 5G 다중 대역 어그리게이션 및 애플리케이션 레이어 성능을 검증했다고 밝혔다. 이번 협력을 통해 낫싱 테크놀로지는 현재 및 미래의 복잡한 5G 대역 어그리게이션 및 애플리케이션 레이어 성능에 대한 모든 규정준수 요건을 충족하고, 새로운 기기를 성공적으로 출시할 수 있었다.
로데슈바르즈와 낫싱 테크놀로지, 새로운 5G 지원 낫싱 폰원 출시 위해 협력R&S CMX500 원박스 신호 테스터를 이용한 R&D 과정의 협력을 통해 낫싱 테크놀로지의 새로운 Phone (1)에 대한 5G 다중 대역 어그리게이션 및 애플리케이션 레이어 성능을 검증했다고 밝혔다. 이번 협력을 통해 낫싱 테크놀로지는 현재 및 미래의 복잡한 5G 대역 어그리게이션 및 애플리케이션 레이어 성능에 대한 모든 규정준수 요건을 충족하고, 새로운 기기를 성공적으로 출시할 수 있었다. 에이엘티, 새로운 모바일 브랜드 ‘마이브’로 ‘스타일 폴더’ 출시마이브(mive) 스타일 폴더는 기존 폴더폰 대비 한층 넓어진 3.97인치 디스플레이에 키패드가 결합된 제품이다. 에이엘티의 신규 브랜드 마이브는 다양한 연령층의 라이프스타일, 멋스러움, 각자가 지닌 고유의 가치와 개성을 공유하며 소통한다는 의미를 담고 있다. 색상은 화이트, 블랙 2종으로 심플하고 고급스러운 디자인과 한손으로 쉽게 조작 가능한 사이즈가 돋보인다.
에이엘티, 새로운 모바일 브랜드 ‘마이브’로 ‘스타일 폴더’ 출시마이브(mive) 스타일 폴더는 기존 폴더폰 대비 한층 넓어진 3.97인치 디스플레이에 키패드가 결합된 제품이다. 에이엘티의 신규 브랜드 마이브는 다양한 연령층의 라이프스타일, 멋스러움, 각자가 지닌 고유의 가치와 개성을 공유하며 소통한다는 의미를 담고 있다. 색상은 화이트, 블랙 2종으로 심플하고 고급스러운 디자인과 한손으로 쉽게 조작 가능한 사이즈가 돋보인다.- 퀀텀, ‘2023 데이터 관리 시장 전망’ 발표퀀텀코리아는 영상관제, 대규모 데이터 스토어, 콘텐츠 및 미디어의 3개 부문에 대한 ‘2023 데이터 관리 시장 전망’을 발표했다.
 조시큐리티, 악성코드 정밀 분석 솔루션 조샌드박스 v36 ‘레인보우 오팔’ 출시코드 네임 ‘Rainbow Opal’로 출시된 이번 릴리즈는 Windows 11 가상/리얼 분석 머신과 맥OS Monterey 리얼 머신을 비롯해 안드로이드 12 가상 분석 머신을 추가로 지원한다. 또한 리버스 엔지니어링 도구인 ‘프리다(Frida)’와의 연동을 지원해, 안드로이드 Cookbook에서 프리다 스크립트를 사용해 안드로이드 샘플을 조작하여 분석할 수 있도록 지원한다. 프리다 아웃풋은 상세 분석 페이지에서 추가로 다운로드 받을 수 있다.
조시큐리티, 악성코드 정밀 분석 솔루션 조샌드박스 v36 ‘레인보우 오팔’ 출시코드 네임 ‘Rainbow Opal’로 출시된 이번 릴리즈는 Windows 11 가상/리얼 분석 머신과 맥OS Monterey 리얼 머신을 비롯해 안드로이드 12 가상 분석 머신을 추가로 지원한다. 또한 리버스 엔지니어링 도구인 ‘프리다(Frida)’와의 연동을 지원해, 안드로이드 Cookbook에서 프리다 스크립트를 사용해 안드로이드 샘플을 조작하여 분석할 수 있도록 지원한다. 프리다 아웃풋은 상세 분석 페이지에서 추가로 다운로드 받을 수 있다.- 마우저, IIoT 애플리케이션을 위한 코보의 초광대역 모듈 제품 공급DWM3001C UWB 모듈은 태그, 액세스 제어, 자산 추적 및 보안 버블 환경을 위한 산업용 사물 인터넷 (IIoT) 애플리케이션을 가속화하도록 설계되었다. 이 완전 통합형 모듈은 공장 및 창고의 자동화, 보안 시스템 등의 애플리케이션에서 UWB 구현을 간소화하며, 의료진 및 환자 애플리케이션, 소매점 보안, 커넥티드 홈, 내비게이션 등을 위한 고정밀 실시간 위치정보를 제공한다.
 kt cloud, HAC 서비스 제공으로 대규모 GPU 활용 문턱 낮췄다kt cloud의 HAC는 대규모 GPU 클러스터를 가상화해 AI 연산∙개발 과정에서 필요한 대규모 GPU 자원을 동적으로 할당∙반납하는 독자적인 기술을 바탕으로, 필요할 때 필요한 만큼만 사용하는 종량제 AI 인프라 서비스다. HAC는 대규모 GPU 인프라 자원을 별도의 구축없이 사용할 수 있어 초거대 AI를 연구∙개발하는 대기업은 물론, 독자적으로 대규모 GPU 인프라 구축과 운영이 어려웠던 AI 스타트업과 대학교 및 연구기관에서 보다 쉽게 이용할 수 있다.
kt cloud, HAC 서비스 제공으로 대규모 GPU 활용 문턱 낮췄다kt cloud의 HAC는 대규모 GPU 클러스터를 가상화해 AI 연산∙개발 과정에서 필요한 대규모 GPU 자원을 동적으로 할당∙반납하는 독자적인 기술을 바탕으로, 필요할 때 필요한 만큼만 사용하는 종량제 AI 인프라 서비스다. HAC는 대규모 GPU 인프라 자원을 별도의 구축없이 사용할 수 있어 초거대 AI를 연구∙개발하는 대기업은 물론, 독자적으로 대규모 GPU 인프라 구축과 운영이 어려웠던 AI 스타트업과 대학교 및 연구기관에서 보다 쉽게 이용할 수 있다. ST, STM32 마이크로컨트롤러용 USB 타입-C PD 소프트웨어로 제품 설계 간소화ST의 X-CUBE-TCPP 소프트웨어 팩은 STM32Cube 에코시스템 개발을 용이하게 하고, ST 포트폴리오에 있는 3개의 USB 타입-C 포트 보호 IC에 라이브러리를 제공한다. 이 라이브러리에는 싱크 애플리케이션용 TCPP01-M12와 소스 애플리케이션용 TCPP02-M18, DRP(Dual-Role Power) 애플리케이션용 TCPP03-M20 등이 있다.
ST, STM32 마이크로컨트롤러용 USB 타입-C PD 소프트웨어로 제품 설계 간소화ST의 X-CUBE-TCPP 소프트웨어 팩은 STM32Cube 에코시스템 개발을 용이하게 하고, ST 포트폴리오에 있는 3개의 USB 타입-C 포트 보호 IC에 라이브러리를 제공한다. 이 라이브러리에는 싱크 애플리케이션용 TCPP01-M12와 소스 애플리케이션용 TCPP02-M18, DRP(Dual-Role Power) 애플리케이션용 TCPP03-M20 등이 있다. 노르딕 세미컨덕터, DECT 포럼의 정회원으로 합류유럽 전기통신표준협회(ETSI)의 DECT NR+는 세계 최초의 비셀룰러 5G 무선 표준으로, 평방 킬로미터당 백만 개에 이르는 장치가 구축되는 고밀도 매시브 IoT를 지원할 수 있도록 설계되었다. DECT NR+는 확장 가능한 대규모 프라이빗 네트워크를 통해 mMTC(massive Machine Type Communication) 및 URLLC(Ultra Reliable Low Latency Communication)와 같은 애플리케이션을 실현할 수 있도록 지원한다.
노르딕 세미컨덕터, DECT 포럼의 정회원으로 합류유럽 전기통신표준협회(ETSI)의 DECT NR+는 세계 최초의 비셀룰러 5G 무선 표준으로, 평방 킬로미터당 백만 개에 이르는 장치가 구축되는 고밀도 매시브 IoT를 지원할 수 있도록 설계되었다. DECT NR+는 확장 가능한 대규모 프라이빗 네트워크를 통해 mMTC(massive Machine Type Communication) 및 URLLC(Ultra Reliable Low Latency Communication)와 같은 애플리케이션을 실현할 수 있도록 지원한다. 암페어, 바이코 파워링 이노베이션 팟캐스트에서 전기항공기에 대한 다양한 인사이트 제시파워링 이노베이션 세 번째 에피소드에서 바이코의 로버트 겐드런(Robert Gendron)은 단거리 화물 비행에서 초음속 운송 기술에 걸친 전기 항공기에 대한 다양한 주제를 가지고 암페어(Ampaire) 최고 기술 책임자인 에드 로블레이스(Ed Lovelace)와 함께 이야기를 나눈다. 암페어는 항공기 전동화 부문을 선도하는 글로벌 기업으로, 항공 혁신 및 환경 지속 가능성 분야에서 수상한 이력이 있다.
암페어, 바이코 파워링 이노베이션 팟캐스트에서 전기항공기에 대한 다양한 인사이트 제시파워링 이노베이션 세 번째 에피소드에서 바이코의 로버트 겐드런(Robert Gendron)은 단거리 화물 비행에서 초음속 운송 기술에 걸친 전기 항공기에 대한 다양한 주제를 가지고 암페어(Ampaire) 최고 기술 책임자인 에드 로블레이스(Ed Lovelace)와 함께 이야기를 나눈다. 암페어는 항공기 전동화 부문을 선도하는 글로벌 기업으로, 항공 혁신 및 환경 지속 가능성 분야에서 수상한 이력이 있다. 인피니언, GaN 기반 업계 최초의 PFC+하이브리드 플라이백 콤보 IC 출시어댑터와 충전기 시장의 발전을 위해서는 낮은 시스템 비용의 소형 폼팩터, 통일된 규격 및 높은 전력 용량이 중요하다. 바로 이러한 요구를 충족하도록 인피니언 테크놀로지스는 새로운 XDP 디지털 파워 XDPS2221을 출시한다고 밝혔다. USB-PD 용 고집적 콤보 컨트롤러 IC XDPS2221은 넓은 입력 및 출력 전압 범위로 최대 28V 출력 전압의 고전력 디자인을 지원한다.
인피니언, GaN 기반 업계 최초의 PFC+하이브리드 플라이백 콤보 IC 출시어댑터와 충전기 시장의 발전을 위해서는 낮은 시스템 비용의 소형 폼팩터, 통일된 규격 및 높은 전력 용량이 중요하다. 바로 이러한 요구를 충족하도록 인피니언 테크놀로지스는 새로운 XDP 디지털 파워 XDPS2221을 출시한다고 밝혔다. USB-PD 용 고집적 콤보 컨트롤러 IC XDPS2221은 넓은 입력 및 출력 전압 범위로 최대 28V 출력 전압의 고전력 디자인을 지원한다.- 서비스나우, 2022 가트너 매직 쿼드런트 ITSM 플랫폼 부문 9년 연속 리더 선정서비스나우는 실행 능력과 비전 완성도를 인정받아 9년 연속 리더로 선정되는 쾌거를 이뤘다. 이와 함께 서비스 운영(3.73/5), 비즈니스 워크플로 자동화(3.81/5) 및 서비스 데스크(3.76/5) 등 IT 서비스 관리 플랫폼에 대한 2022 가트너 핵심 기능 내 3가지 사용 사례 모두에서 2022년 9월 23일 기준 최고 점수를 받았다.
- 앤시스, 뉴스위크의 ‘미국에서 가장 책임감있는 기업’으로 선정이 권위 있는 상은 뉴스위크와 세계 최고의 통계 포털 및 업계 순위 제공기업인 스타티스타(Statista Inc.)가 수여한다. 미국에서 가장 책임 있는 기업은 CSR 보고서, 지속 가능성 보고서 및 기타 보고서와 독립적인 설문 조사에서 제공하는 공개적으로 사용 가능한 핵심 성과 지표를 기반으로 선정되었다.
 인텔 파운드리, 고개구율 극자외선(High-NA EUV) 도입으로 칩 제조 분야 선도
인텔 파운드리, 고개구율 극자외선(High-NA EUV) 도입으로 칩 제조 분야 선도 NXP, 연간 기업 지속 가능성 보고서 - ESG 목표 달성 현황 공개
NXP, 연간 기업 지속 가능성 보고서 - ESG 목표 달성 현황 공개 로데슈바르즈, 획기적인 성능으로 무장한 R&S NGC100 파워 서플라이 제품군 신규 출시
로데슈바르즈, 획기적인 성능으로 무장한 R&S NGC100 파워 서플라이 제품군 신규 출시 IMDT와 Hailo가 합작하여 최고의 실시간 성능을 위한 엣지 AI 솔루션 출시
IMDT와 Hailo가 합작하여 최고의 실시간 성능을 위한 엣지 AI 솔루션 출시 콩가텍, 인텔 코어 i3 및 인텔 아톰 x7000RE 프로세서 탑재 SMARC 모듈 출시
콩가텍, 인텔 코어 i3 및 인텔 아톰 x7000RE 프로세서 탑재 SMARC 모듈 출시
- 인텔, 세계 최대규모 뉴로모픽 시스템 공개
- 마이크로칩, 항공기 전기화 전화를 간소화하는 통합 구동 파워 솔루션 출시
- 텔레다인르크로이, 광범위한 통신 기술 데이터를 원활하게 포착하는 프론트라인 X500e 출시
- TTTech Auto, 복잡한 소프트웨어 통합을 혁신할 차세대 스케줄러 ‘MotionWise Schedule’ 출시
- 아이스아이, 글로벌 SAR 리더십 확장을 위한 기업의 성장 펀딩 라운드 초과 달성
- 오나인솔루션즈, 생성형 AI 기술 적용해 ‘o9 Digital Brain’ 플랫폼 강화
그래픽 / 영상
 결정론, 새로운 이더넷 애플리케이션을 열다
결정론, 새로운 이더넷 애플리케이션을 열다 AMD, 새로운 2세대 버설 적응형 SoC로 AI 기반 임베디드 시스템의 종단간 가속 지원
AMD, 새로운 2세대 버설 적응형 SoC로 AI 기반 임베디드 시스템의 종단간 가속 지원 2024년, 디스플레이 글래스 산업 공급부족 우려
2024년, 디스플레이 글래스 산업 공급부족 우려
많이 본 뉴스
 AMD 적응형 컴퓨팅 기술, 소니의 자동차용 라이다 레퍼런스 디자인 지원
AMD 적응형 컴퓨팅 기술, 소니의 자동차용 라이다 레퍼런스 디자인 지원 가트너, “AI 코드 어시스턴트 사용 2028년까지 급증” 전망
가트너, “AI 코드 어시스턴트 사용 2028년까지 급증” 전망 에이디링크, 첨단 엣지 산업용 및 AI 솔루션을 위해 14세대 인텔 프로세서 지원 발표
에이디링크, 첨단 엣지 산업용 및 AI 솔루션을 위해 14세대 인텔 프로세서 지원 발표 마이크로칩, Qi v2.0 무선 충전 표준 준수 dsPIC33 기반 레퍼런스 디자인 출시
마이크로칩, Qi v2.0 무선 충전 표준 준수 dsPIC33 기반 레퍼런스 디자인 출시 엔비디아, RTX AI PC 사용자 위해 하드웨어부터 소프트웨어까지 지원
엔비디아, RTX AI PC 사용자 위해 하드웨어부터 소프트웨어까지 지원 KT, 5G와 위성 상용 주파수 지원하는 RIS 기술 개발
KT, 5G와 위성 상용 주파수 지원하는 RIS 기술 개발 ST의 NFC 리더기, 비용 대비 뛰어난 성능의 내장형 비접촉식 인터랙션 구현
ST의 NFC 리더기, 비용 대비 뛰어난 성능의 내장형 비접촉식 인터랙션 구현 인텔, 파운드리 사업 위한 재무 구조 개편 및 수익성 확대 방안 설정
인텔, 파운드리 사업 위한 재무 구조 개편 및 수익성 확대 방안 설정 로데슈바르즈, NTN NB-IoT 테스트 케이스의 신규 GCF 인증 획득
로데슈바르즈, NTN NB-IoT 테스트 케이스의 신규 GCF 인증 획득 Ceva, 연결 기능을 강화한 멀티 프로토콜 무선 플랫폼 IP 공개
Ceva, 연결 기능을 강화한 멀티 프로토콜 무선 플랫폼 IP 공개
